记住用户名密码
Chem. Eng. J. | 突破SALD “速度与污染”制衡:定量模型与智能优化实现高效低耗薄膜沉积
纳米级功能薄膜是太阳能电池、发光二极管(LED)和柔性显示器等现代高性能设备的核心组成部分。原子层沉积(ALD)技术凭借其自限制生长特性而闻名于世。然而,传统ALD中的净化步骤常常耗时较长,沉积速率因此受到限制。空间原子层沉积(SALD)通过物理分离前驱体区域并结合衬底的精确移动,实现了比传统ALD快两个数量级的沉积速率,同时保持了ALD的高精度和优势。然而,“快”也有快的烦恼。快速的基底移动缩短了前驱体的暴露时间,可能导致每次循环生长(GPC)降低。此外,移动基底引起的气流夹带,把前一个区域的化学物质“卷”到下一个区域去,这两种化学物质一旦提前相遇,就会在腔体中发生不想要的化学反应 (CVD)。CVD 产物就像空气中的灰尘,会污染薄膜,导致薄膜不均匀、不致密,甚至出现颗粒。为了弥补GPC下降和减低CVD污染,又不得不消耗更多宝贵的前驱体和惰性气体。
为了解决这个“又快又好”的难题,研究建立了一个定量的模型,用于深入理解衬底速度对CVD污染的影响机制。该模型不仅基于原子层沉积(ALD)的吸附动力学理论,还耦合了流体动力学模型来模拟前驱体的传质和反应(如图1所示),并首次型建立了CVD污染于基底速度的函数关系。
通过该模型揭示了一个关键秘密:基底的快速移动会通过粘性力和流体层间的剪切力,在基底表面形成气体夹带层。这层夹带层会携带前驱体运动,从而增强了反应器内部前驱体的对流和扩散传质。随着基底速度的提高,夹带层变厚,使得前驱体(如H2O)更容易迁移到N2阻挡层区域并与另一前驱体(TMA)混合,导致明显的CVD污染,如图2所示。
既然“夹带层”是关键因素,那怎么阻止它呢?研究发现,增加微间隙内的气体流速对于防止前驱体夹带至关重要,这有助于在快速基底移动下保持ALD的性能和薄膜质量。通过调整工艺参数,例如增加隔离N2流速、降低背景压力以及减小微间隙尺寸,可以有效增强阻挡层流速,减少夹带层厚度,从而将高质量的ALD阶段扩展到更高的基底速度,如图3所示。
此外,快速低消耗的制造ALD薄膜需要调整多种参数,比如气体流量、化学物质浓度、基底速度、微间隙大小等等,这些参数组合起来可能有几百万甚至几千万种可能。如果一个个去试,那将是天文数字的工作量!
这时,本课题组开发了一个智能优化助手——由高斯过程回归和自定义采集策略驱动的主动学习框架,该框架在三种不同的基底速度下进行了优化,面对高达7700万种可能的参数组合,仅需进行115次计算就成功找到了最优条件,展示了极高的计算效率,如图4所示。优化结果令人瞩目:在0.15 m/s的基底速度下,该方法实现了气体消耗降低31%,前驱体消耗降低15%。优化后的策略表明,有效降低前驱体流速是实现最低消耗的关键。研究团队指出,该方法同样适用于其他更高的基底速度。更重要的是,通过真实的实验验证,在这些优化后的条件下制备出的薄膜,其厚度均匀性、致密度和表面粗糙度都与传统的、慢速的 ALD 技术不相上下。
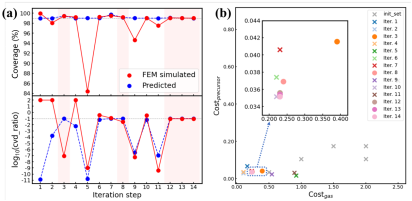
这项研究如同为 SALD 高速生产线找到了“优化方案”和“智慧大脑”,不仅深刻揭示了高速移动下薄膜沉积的关键物理和化学机制,更提供了一套高效、节约的优化方法,为未来更快速、更经济地制造高性能纳米薄膜奠定了基础。
相关成果以“Quantitative modeling of substrate velocity effects on deposition efficiency and precursor consumption in spatial ALD” 为题发表在国际著名期刊Chemical Engineering Journal上。华中科技大学材料学院硕士马更为第一作者,华中科技大学材料科学与工程学院的单斌教授和机械科学与工程学院的杨帆副研究员为论文的共同通讯作者,华中科技大学材料学院文艳伟副教授、王昭杰博士、蒋雪微博士以及来自机械科学与工程学院的陈蓉教授、高远教授和圣路易斯华盛顿大学的李邹霜博士后共同参与了该项研究工作。